分享:雙脈沖HiPIMS放電特性及CrN薄膜高速率沉積
哈爾濱工業(yè)大學先進焊接與連接國家重點實驗室 哈爾濱 150001
提出了一種新型的高功率脈沖磁控濺射(HiPIMS)技術,即放電由脈寬短、電壓高的引燃脈沖和脈寬長、電壓低的工作脈沖2部分組成的雙脈沖高功率脈沖磁控濺射技術,目的是解決傳統(tǒng)高功率脈沖磁控濺射沉積速率低的問題。研究了引燃脈沖電壓及傳統(tǒng)高功率脈沖磁控濺射條件對Cr靶在Ar氣氣氛下的放電特性的影響,并制備CrN薄膜。結果表明:隨著引燃脈沖電壓的施加,雙脈沖高功率脈沖磁控濺射Cr靶放電瞬間建立,并獲得較高的峰值電流,而傳統(tǒng)HiPIMS模式的輸出是漸漸爬升的三角波電流;與傳統(tǒng)高功率脈沖磁控濺射相比,單位功率下雙脈沖高功率脈沖磁控濺射具有更高的基體電流積分以及更多的Ar+和Cr0數(shù)量;引燃脈沖電壓為590 V時,雙脈沖高功率脈沖磁控濺射單位功率下CrN薄膜沉積速率為2.52 μm/(h·kW),比傳統(tǒng)高功率脈沖磁控濺射提高近3倍。
關鍵詞:
磁控濺射技術以其沉積溫度低[1]、膜層均勻性好[2]、膜層無大顆粒(陰極弧沉積中很難避免)[3]等特點廣泛應用于工業(yè)鍍膜領域,然而傳統(tǒng)直流磁控濺射(direct current magnetron sputtering,DCMS)存在等離子體密度低(1014~1016 m-3)[4]、濺射粒子離化率低(<10%)等問題[5,6],不利于膜層質量的提高。自1999年Kouznetsov等[7]首次提出高功率脈沖磁控濺射(high power impulse magnetron sputtering,HiPIMS)以來受到研究者的廣泛關注,其通過低占空比(<10%)、低頻率(<10 kHz)的高電壓脈沖產(chǎn)生脈沖高峰值靶功率密度(如0.1~3 kW/cm2)[8,9],從而獲得高等離子體密度(1018 m-3)[4]、高金屬離化率(對Cu和Cr達到70%)[10]。但是HiPIMS沉積速率低,僅為DCMS的15%~70%[11],極大限制了HiPIMS的工業(yè)應用。普遍認為,在脈沖期間,由于靶材較高的負壓,被離化粒子重新回吸到靶面是引起其沉積速率下降的主要原因[12]。
因此,提高沉積速率一直是HiPIMS研究的熱點。Paulitsch等[13]采用HiPIMS和DCMS沉積CrNHiPIMS/TiNDCMS多層膜,膜層具有較高的硬度(約25 GPa)和較低的摩擦系數(shù)(0.05),且沉積速率得到改善。Luo等[14]采用1個HiPIMS靶復合3個DCMS靶同時沉積TiN薄膜,其沉積速率達到0.047 μm/min,并使膜層殘余應力降低,膜層硬度提高,其沉積速率的提高主要是由于在沉積過程中3個DCMS靶起主導作用。Stranak等[15]在HiPIMS的脈沖間隙增加中頻濺射輔助沉積,發(fā)現(xiàn)中頻產(chǎn)生的預離化作用能使膜層沉積速率增加、可工作氣壓降低以及濺射效率提高。Lu等[16]采用在HiPIMS脈沖間隙疊加中頻脈沖的方法沉積TiCrBN薄膜,發(fā)現(xiàn)TiCrBN薄膜的沉積速率隨著Ti靶的狀態(tài)由中毒狀態(tài)向過渡狀態(tài)的轉變而提高了1.64倍。可以發(fā)現(xiàn),上述方法中沉積速率的提高主要是通過額外添加另一種沉積速率較高的放電模式如DCMS、中頻濺射,使系統(tǒng)總功率提高,并未從HiPIMS放電及控制本身來提高沉積速率。
由于較高的靶電壓造成了離子的回吸,本工作設想能否采用一種特殊設置的放電電壓波形。先利用一個高脈沖電壓引燃等離子體,然后迅速降低靶電壓,并利用等離子體的非線性效應,使得低靶壓也能維持住較高的靶電流。綜合效果既提高了等離子體密度,又因為減弱離子回吸而提高沉積速率。因此本工作提出了一種由高、低脈沖電壓組成的復合波形HiPIMS技術。利用高的引燃脈沖電壓瞬間激發(fā)大電流,獲得高的等離子體密度,在較低電壓的工作脈沖下維持放電,減弱靶材對被離化粒子的回吸效應。本工作利用雙脈沖HiPIMS電源,研究了引燃脈沖放電對Cr靶在Ar氣氣氛下的放電以及所制備的CrN膜層結構特征及沉積速率的影響,以期在同樣的輸入功率下獲得高的等離子體密度的同時,比傳統(tǒng)HiPIMS技術具有更高的沉積速率。
實驗采用自行研制的多功能真空鍍膜系統(tǒng),如圖1所示。該系統(tǒng)主要是由真空室、抽氣系統(tǒng)(包括機械泵、分子泵)、供氣系統(tǒng)、冷卻系統(tǒng)以及控制系統(tǒng)等組成。真空室是尺寸為直徑800 mm×600 mm的不銹鋼圓柱體結構。實驗選用純度為99.99%的Cr靶,Cr靶的尺寸為400 mm×100 mm×13 mm,背底真空1×10-3 Pa。電源系統(tǒng)包含自行研制的雙脈沖高功率脈沖電源和傳統(tǒng)高功率脈沖電源2個磁控濺射源,該雙脈沖高功率脈沖電源系統(tǒng)引燃脈沖電壓最高可達2000 V,工作脈沖電壓可達1000 V,頻率為100~1500 Hz,占空比連續(xù)可調。實驗放電在Ar氣氣氛下進行,工作氣壓保持在0.5 Pa,偏壓-100 V,占空比75%。雙脈沖HiPIMS放電過程中,引燃脈沖電壓分別為530、550、570、590、610和630 V,脈寬為20 μs,工作脈沖電壓為380 V,脈寬為130 μs,頻率500 Hz。傳統(tǒng)HiPIMS放電過程中,脈沖電壓為400 V,脈寬為150 μs,頻率500 Hz。
圖1 雙脈沖高功率脈沖磁控濺射(HiPIMS)沉積系統(tǒng)示意圖
Fig.1 Schematic of the dual-pulse high power impulse magnetron sputtering (HiPIMS) deposition system
分別利用雙脈沖HIPIMS和傳統(tǒng)HIPIMS制備CrN薄膜。CrN薄膜沉積前,利用空心陰極等離子體源對工件進行清洗,空心陰極放電電流為40 A,空心陰極線圈電流0.4 A;CrN薄膜的制備包含Cr過渡層沉積和CrN薄膜沉積,Cr過渡層沉積參數(shù)為:工件偏壓-400 V,占空比50%,沉積10 min;-200 V偏壓,占空比75%,沉積5 min;-100 V偏壓,占空比75%,沉積5 min。CrN薄膜沉積時,Ar流量和N2流量分別為30和5 mL/min,工作氣壓保持在0.5 Pa,偏壓-100 V,占空比75%,沉積50 min。雙脈沖HiPIMS制備CrN薄膜過程中,引燃脈沖電壓分別為530、560、590和620 V,脈寬為20 μs,工作脈沖電壓為380 V,脈寬為130 μs,頻率500 Hz。傳統(tǒng)HiPIMS制備CrN薄膜過程中,脈沖電壓為400 V,脈寬為150 μs,頻率500 Hz。
式中,U為在t時刻靶材瞬時電壓,I為在t時刻靶材瞬時電流,T為脈沖周期。利用式(4)可計算出每個周期內的基體電流積分(Q):
采用Avaspec-2048型光譜儀檢測真空室等離子體發(fā)射光譜,其探測的光譜范圍為300~900 nm。采用Helions NanoLab 600i聚焦離子束/電子束雙束掃描電子顯微鏡(SEM)對CrN薄膜表面以及截面形貌進行觀察,通過薄膜截面形貌可測定薄膜厚度并根據(jù)沉積時間計算沉積速率;采用D8 ADVANCE X射線衍射儀(XRD)對CrN薄膜進行結構分析。
圖2為雙脈沖HiPIMS不同引燃脈沖電壓(工作脈沖電壓為380 V)及傳統(tǒng)HiPIMS脈沖電壓為400 V條件下Cr靶靶電壓和靶電流波形圖。由圖2a可見,雙脈沖HiPIMS的電壓波形由脈沖開始階段的脈寬短、電壓高的引燃脈沖以及隨后脈寬長、電壓低的工作脈沖2部分組成,引燃脈沖的存在對靶電流波形產(chǎn)生明顯影響。從圖2b中可以發(fā)現(xiàn),傳統(tǒng)HiPIMS靶電流呈典型的三角波形,電流逐漸上升,最大為近40 A;而對于雙脈沖HiPIMS,靶電流迅速上升,且隨著引燃脈沖的增加,峰值靶電流明顯增加。當引燃脈沖電壓達到630 V時,靶峰值電流甚至接近100 A。Anders等[18]指出,靶電流主要由靶面正離子碰撞和靶表面的二次電子發(fā)射引起,靶電流的平臺值與靶材的自濺射有關[17]。對于雙脈沖HiPIMS,在引燃脈沖為530 V時,一旦高脈沖停止靶材電流迅速下降,出現(xiàn)電流最小值,這是由于引燃放電還不夠強烈或者說平臺電壓較低,靶材耦合放電突降。隨著靶材引燃脈沖電壓的升高,引燃脈沖階段產(chǎn)生的靶峰值電流明顯提高,激發(fā)出大量等離子體;隨后引燃脈沖向工作脈沖過渡,靶電流逐漸減小,但是仍然高于常規(guī)HiPIMS模式的脈沖電流,表明這種雙脈沖模式即使在低的工作電壓時也能維持較高的等離子體密度。可以發(fā)現(xiàn),這種雙脈沖放電模式能夠使靶電流長時間處于較高的電流,這對于等離子體密度的提高是有利的[19]。靶電流平臺值的出現(xiàn)與高脈沖誘導的高密度等離子體及靶材自濺射效應增強有關。
圖2 雙脈沖HiPIMS不同引燃脈沖電壓及傳統(tǒng)HiPIMS條件下靶電壓和靶電流波形圖
Fig.2 Waveforms of target voltage (a) and target current (b) of conventional HiPIMS and dual-pulse HiPIMS with different ignition voltages (Inset in Fig.2a shows the enlarged view)
圖3 雙脈沖HiPIMS引燃脈沖電壓及HiPIMS條件對靶材平均功率的影響
Fig.3 Influence of ignition pulse voltage of dual-pulse HiPIMS and conventional HiPIMS on average target power
圖4為雙脈沖HiPIMS不同引燃脈沖電壓(工作脈沖電壓為380 V)及傳統(tǒng)HiPIMS脈沖電壓為400 V條件下基體電流隨時間變化的波形圖。可見,傳統(tǒng)HiPIMS基體電流隨著靶材電流的增加而增加,當脈沖截止(即達到150 μs)時,基體電流開始逐漸減小直至減小到0 A。對于雙脈沖HiPIMS,引燃脈沖電壓為530 V時,基體電流在初始階段逐漸升高,達到峰值電流0.25 A。隨著引燃脈沖電壓的增大,基體峰值電流逐漸增大,由0.25 A增加到630 V時的0.5 A,且達到基體峰值電流的時間逐漸前移。在引燃脈沖電壓為630 V時,基體電流在初始階段迅速升高,這是由于引燃脈沖電壓的提高,使初始階段靶材電流迅速達到極大值(圖2),飛向靶材的離子數(shù)量明顯增多,靶材濺射速率提高,此時等離子體密度迅速提高,到達基體的離子數(shù)量增加,基體峰值電流明顯提高[21]。
圖4 雙脈沖HiPIMS不同引燃脈沖電壓及HiPIMS條件下基體電流波形圖
Fig.4 Waveforms of substrate current for conventional HiPIMS and dual-pulse HiPIMS with different ignition voltages
圖5為雙脈沖HiPIMS不同引燃脈沖電壓(工作脈沖電壓為380 V)及傳統(tǒng)HiPIMS脈沖電壓為400 V條件下單位功率基體電流積分的變化。基體電流能夠間接反映到達基體的離子數(shù)量[22],本工作利用一個脈沖周期內基體電流積分近似表征一個脈沖周期內到達基體離子的數(shù)量。可見,傳統(tǒng)HiPIMS單位功率下基體電流積分為10.06×10-5 C/kW,而不同引燃脈沖電壓下的雙脈沖HiPIMS單位功率下基體電流積分值在12.75×10-5~13.88×10-5 C/kW范圍內變化,均高于傳統(tǒng)HiPIMS。說明在單位靶功率下雙脈沖HiPIMS模式到達基體的離子數(shù)量更多。值得注意的是,存在一個最佳的引燃脈沖電壓,超過這個電壓,單位靶功率對到達基體的離子流量的貢獻率下降,這可能與引燃脈沖期間較高靶壓的離子回吸[23,24]以及等離子體消耗的非線性效應有關。如圖6所示,相比于傳統(tǒng)HiPIMS,雙脈沖HiPIMS脈沖包含脈寬短、電壓高的引燃脈沖和脈寬長、電壓低的工作脈沖2部分。引燃脈沖產(chǎn)生劇烈放電,激發(fā)出大電流,獲得較高的等離子體密度;工作脈沖期間靶電壓降低,但基于等離子體的非線性仍能維持較高的放電電流,較低的靶電壓將使得回吸離子數(shù)量占比下降,最終體現(xiàn)為單位功率下基體電流積分增加。
圖5 雙脈沖HiPIMS引燃脈沖電壓及HiPIMS條件對單位功率基體電流積分的影響
Fig.5 Influence of ignition pulse voltage of dual-pulse HiPIMS and conventional HiPIMS on the substrate current integral at unit power
圖6 傳統(tǒng)HiPIMS及雙脈沖HiPIMS放電機理示意圖
Fig.6 Schematics of the discharge mechanism of conventional HiPIMS (a) and dual-pulse HiPIMS (b)
圖7為雙脈沖HiPIMS引燃脈沖電壓分別為530、550、570、590、610和630 V時(工作脈沖電壓為380 V)及傳統(tǒng)HiPIMS脈沖電壓為400 V條件下Ar+ (波長分別為529.80、534.56和540.94 nm)和Cr0 (波長分別為360.50、425.43和428.97 nm)單位功率下的特征光譜強度變化。一般來講,發(fā)射光譜強度越高,所代表的粒子數(shù)量越多[25]。可以看出,單位功率下,Ar+的特征光譜強度變化趨勢與Cr0的特征光譜強度變化趨勢類似,雙脈沖HiPIMS的Ar+和Cr0的特征光譜強度均高于傳統(tǒng)HiPIMS,且雙脈沖HiPIMS隨著引燃脈沖電壓的增加,Ar+和Cr0的特征光譜強度呈上升趨勢。其原因由圖2可知,相比于傳統(tǒng)HiPIMS,雙脈沖HiPIMS由于引燃脈沖的存在使靶電流在短時間內達到極大值,且隨著引燃脈沖電壓提高峰值靶電流明顯提高,氣體放電更加強烈,導致Ar+數(shù)量增加,等離子體密度提高,同時靶電流的增加,說明飛向靶材的離子數(shù)量增加,使靶材濺射速率提高,導致靶材表面Cr0數(shù)量增加。
圖7 雙脈沖HiPIMS引燃脈沖電壓及HiPIMS條件對Ar+和Cr0的單位功率特征光譜強度的影響
Fig.7 Influence of ignition pulse voltage of dual-pulse HiPIMS and conventional HiPIMS on the optical spectrum intensity of Ar+ (a) and Cr0 (b) at unit power
圖8為雙脈沖HiPIMS和傳統(tǒng)HiPIMS模式制備的CrN薄膜的表面與截面微觀形貌的SEM像。可見,5組CrN薄膜均呈柱狀晶生長。采用傳統(tǒng)HiPIMS制備的CrN薄膜表面形貌主要呈“菜花”狀[26],柱狀晶生長較為致密。采用雙脈沖HiPIMS制備的CrN薄膜,在引燃脈沖電壓為530 V時,其表面形貌主要呈多角錐狀結構,且晶粒與晶粒之間空隙明顯,柱狀晶排列較為疏松,柱狀晶間存在孔洞,說明該組復合波形獲得的膜層不夠致密。當引燃脈沖為560 V時,表面形貌由多角錐狀轉化為片狀,相比引燃脈沖電壓530 V時表面空隙減少,柱狀晶間孔洞消失。當引燃脈沖電壓為590 V時,表面空隙幾乎消失,柱狀晶排列緊密,且發(fā)現(xiàn)柱狀晶生長中斷現(xiàn)象。當引燃脈沖電壓提高為620 V時,表面形貌明顯變化,呈“米粒”狀結構,每個“大米粒”由多個“小米粒”組成,柱狀晶排列更加緊密。這表明雙脈沖HiPIMS隨著引燃脈沖電壓的提高,高密度等離子體迅速產(chǎn)生,對基體的轟擊能量提高[27],促進了晶粒的重復形核和沉積粒子的擴散遷移[28],使柱狀晶生長被打斷[8,29],并減少缺陷[30],使膜層更加致密[31]。
圖8 雙脈沖HiPIMS不同引燃脈沖電壓及HiPIMS條件下CrN薄膜表面與截面形貌的SEM像
Fig.8 Surface (a, c, e, g, i) and cross-sectional (b, d, f, h, j) SEM images of CrN coatings deposited by conventional HiPIMS (a, b) and dual-pulse HiPIMS with ignition pulse voltages of 530 V (c, d), 560 V (e, f), 590 V (g, h) and 620 V (i, j)
圖9給出了雙脈沖HiPIMS條件下制備的CrN薄膜的XRD譜。可見,制備的CrN薄膜主要有3個衍射峰,包括(111)CrN、(200)CrN以及(210)Cr。在引燃脈沖電壓為530 V時,制備的薄膜中含有(210)Cr,說明此時N2離化不夠。隨著引燃脈沖電壓的升高,Cr峰逐漸消失,(200)CrN峰開始凸起。這可能是由于隨著引燃脈沖電壓的升高,靶電流明顯增加,對N2的離化和激發(fā)作用增強,更多的Cr與N結合生成CrN,導致Cr峰減小,(200)CrN峰開始凸起。同時隨著引燃脈沖電壓的升高,(111)CrN峰的峰位逐漸向小角度偏移,這表明隨著引燃脈沖電壓的升高,晶格點陣畸變增加,這與隨著引燃脈沖電壓的增加,離子對基體轟擊作用增強有關[32]。利用Scherrer公式[33,34]近似計算(111)CrN的晶粒尺寸,晶粒尺寸隨引燃脈沖電壓變化如圖10所示。可以看出,隨著引燃脈沖電壓從530 V提高到620 V,晶粒尺寸分別為34、27、26和19 nm,即隨著引燃脈沖電壓的增加,由于離子對基體轟擊作用的增強,CrN薄膜的晶粒尺寸逐漸減小[35]。
圖9 雙脈沖HiPIMS不同引燃脈沖電壓下CrN薄膜的XRD譜
Fig.9 XRD spectra of CrN coatings deposited by dual-pulse HiPIMS with different ignition pulse voltages
圖10 雙脈沖HiPIMS引燃脈沖電壓對CrN薄膜晶粒尺寸的影響
Fig.10 Influence of ignition pulse voltage of dual-pulse HiPIMS on the grain size of CrN coatings
從CrN薄膜的截面SEM像可以看出,傳統(tǒng)HiPIMS條件下薄膜厚度為0.321 μm,雙脈沖HiPIMS條件下,引燃脈沖電壓從530 V到620 V,薄膜厚度分別為0.326、0.438、1.76以及1.38 μm。可以計算出單位功率下2種模式的薄膜沉積速率,如圖11所示。可以看出,單位功率下,傳統(tǒng)HiPIMS的沉積速率僅為0.60 μm/(h·kW),而雙脈沖HiPIMS的沉積速率均高于傳統(tǒng)HiPIMS,特別是在引燃脈沖電壓為590 V時,單位功率沉積速率達到2.52 μm/(h·kW),比傳統(tǒng)HiPIMS的沉積速率提高近3倍。單位功率沉積速率的提高可從兩方面考慮[36]:一方面相比傳統(tǒng)HiPIMS,雙脈沖HiPIMS中引燃脈沖瞬間激發(fā)大的靶電流,并通過工作脈沖使靶電流維持在較高水平,從而使等離子體密度提高,結合圖7可知,單位功率下,雙脈沖HiPIMS中靶材濺射產(chǎn)生更多的Cr0可用于沉積;另一方面,由圖5可知,單位功率下,雙脈沖HiPIMS基體電流積分均高于傳統(tǒng)HiPIMS,雙脈沖HiPIMS條件下靶材回吸離子作用相對減弱,單位功率下到達基體的離子數(shù)量更多。當引燃脈沖為620 V時,單位功率下的沉積速率下降,根據(jù)薄膜表面及截面形貌和XRD譜分析,這可能與在引燃脈沖為620 V時,離子對基體的轟擊強度較高導致的反濺射作用增強、薄膜致密化等因素有關[25]。從另外一個角度,也可能與離子回吸、等離子體消耗非線性等因素有關。
圖11 雙脈沖HiPIMS引燃脈沖電壓及HiPIMS條件對CrN薄膜單位功率沉積速率的影響
Fig.11 Influence of ignition pulse voltage of dual-pulse HiPIMS and conventional HiPIMS on the deposition rate at unit power
(1) 雙脈沖HiPIMS中,隨著引燃脈沖電壓的增加,Cr靶放電很快建立,Cr靶峰值電流明顯提高,這與傳統(tǒng)HiPIMS中靶電流波形呈三角波逐漸升高的特征有明顯區(qū)別。雙脈沖HiPIMS單位功率下的基體電流積分均高于傳統(tǒng)HiPIMS。
(2) 相比于傳統(tǒng)HiPIMS,雙脈沖HiPIMS具有更高的等離子體密度和更高的Cr靶濺射速率,其單位功率下的Ar+和Cr0數(shù)量均高于傳統(tǒng)HiPIMS,且隨著引燃脈沖電壓的提高,單位功率下的Ar+和Cr0數(shù)量呈上升趨勢。
(3) 單位功率下,雙脈沖HiPIMS比傳統(tǒng)HiPIMS具有更高的CrN薄膜沉積速率,特別是引燃脈沖電壓為590 V時,單位功率下CrN薄膜沉積速率為2.52 μm/(h·kW),比傳統(tǒng)HiPIMS提高近3倍。且隨著引燃脈沖電壓的提高,雙脈沖HiPIMS制備的CrN薄膜更加致密,晶粒更加細小。
(4) 獲得了一種高沉積速率的高功率脈沖磁控濺射技術,有望推動高離化磁控濺射技術的進步。
1 實驗方法
圖1

2 實驗結果與分析
2.1 引燃脈沖對磁控靶放電電流的影響
圖2
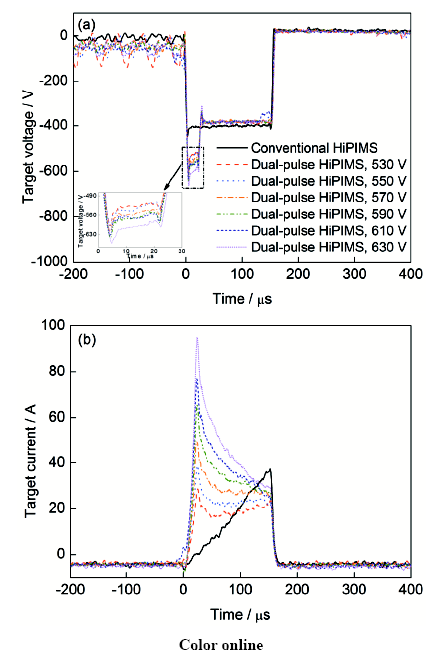
圖3
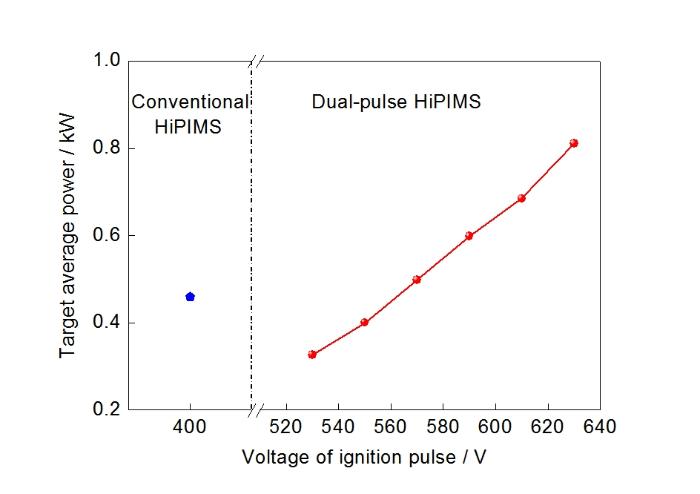
2.2 引燃脈沖電壓對基體電流的影響
圖4

圖5
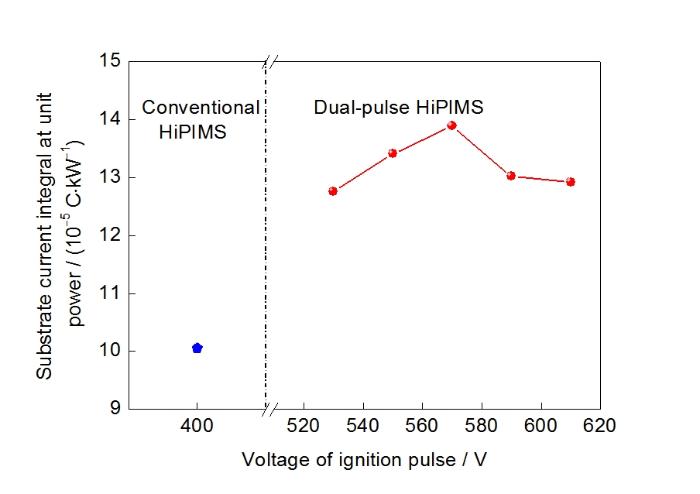
圖6
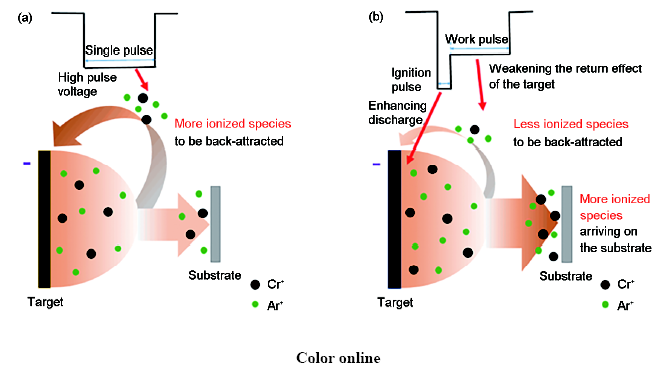
2.3 引燃脈沖電壓對粒子特征光譜強度的影響
圖7
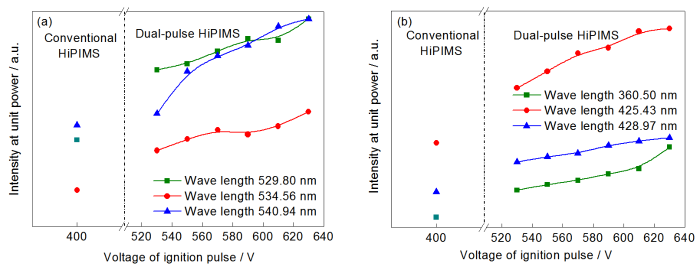
2.4 引燃脈沖電壓對CrN薄膜結構特征的影響
圖8
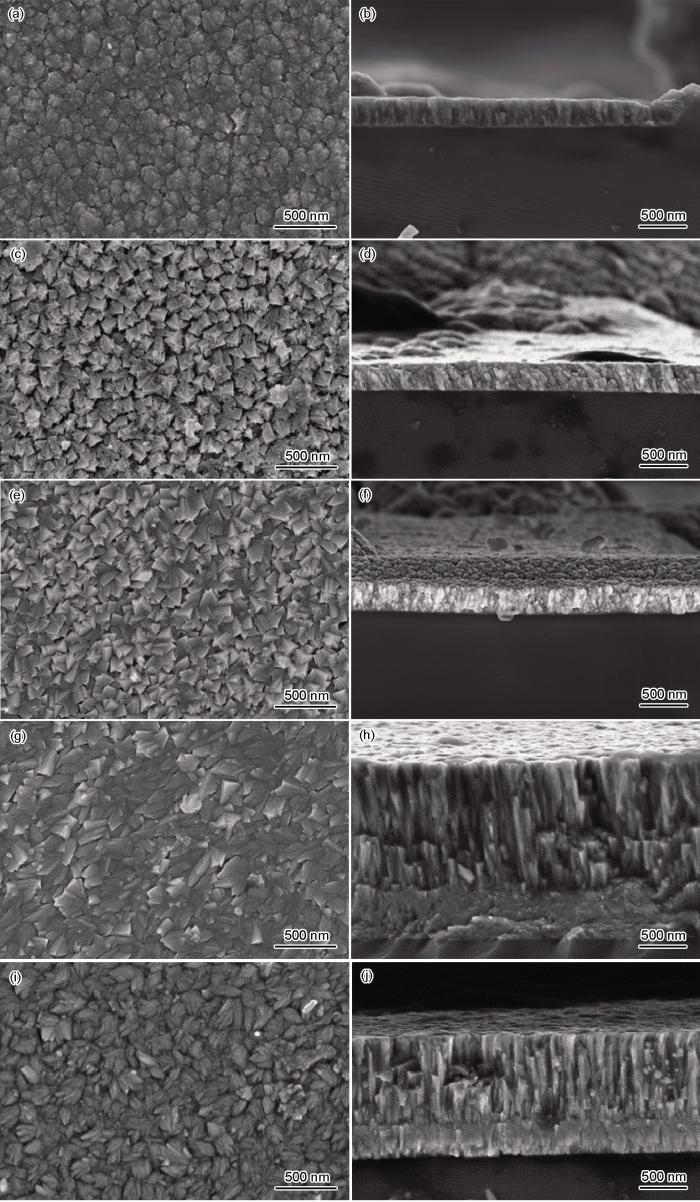
圖9
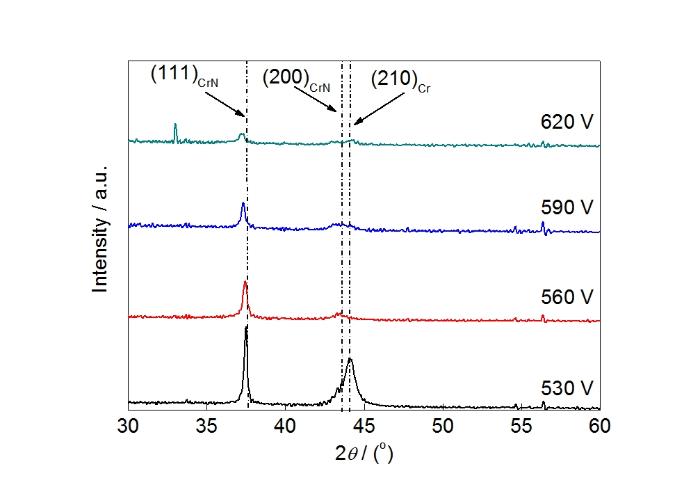
圖10

圖11
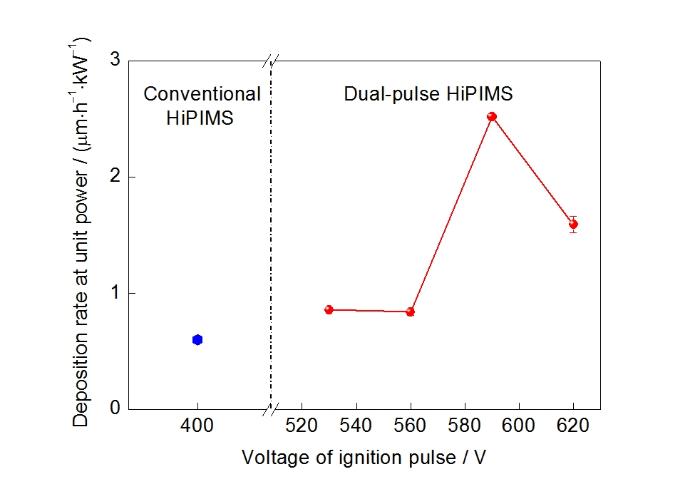
3 結論
來源--金屬學報







 滬公網(wǎng)安備31011202020290號
滬公網(wǎng)安備31011202020290號
